合作客户/
拜耳公司 |
同济大学 |
联合大学 |
美国保洁 |
美国强生 |
瑞士罗氏 |
相关新闻Info
推荐新闻Info
-
> 表面张力仪应用:解锁固相推进剂界面粘附性能的关键“标尺”
> 以表面张力仪为钥:揭秘极端环境CAFS性能演变的核心实验平台
> 界面张力仪的关键证据:量化润湿性变化阐明改性碳烟润滑增效机制
> 从界面张力到摩擦性能:改性生物柴油碳烟作为水基润滑添加剂的构效关系分析
> 芬兰Kibron SuperG超微量天平技术参数详解与选购指南
> 五种表面活性剂对粉煤灰基多孔地聚物孔结构与力学性能的调控机制(二)
> 五种表面活性剂对粉煤灰基多孔地聚物孔结构与力学性能的调控机制(一)
> 粉煤灰基多孔地聚物:五种表面活性剂降低碱液表面张力与稳定泡沫的效能对比
> 表面活性剂对粉煤灰基多孔地聚物孔结构及性能的调控机制研究
> 人工模拟瘤胃体外发酵技术:纤维发酵中比表面积与表面张力的调控作用(二)
动态表面张力在半导体晶圆清洗工艺的应用
来源:翁开尔公司 浏览 2221 次 发布时间:2022-03-21
5G、人工智能、智慧交通等消费电子、汽车电子、计算机等应用领域的发展,对芯片的性能提出更高的要求,加快了芯片制程升级,从而带动了半导体行业的发展。半导体晶圆制造工艺包括清洗、曝光、显影、刻蚀、CMP(化学机械抛光)、切片等环节,需要用到各种特殊的液体,如显影液,清洗液,抛光液等等,这些液体中表面活性剂的浓度对工艺质量效果产生深刻的影响。

动态表面张力在半导体晶圆清洗工艺的应用
半导体晶圆清洗工艺要求
芯片制造技术的进步驱动半导体清洗技术快速发展。在单晶硅片制造中,光刻,刻蚀,沉积等工艺后均设置了清洗工艺,清洗工艺在芯片制造进程中占比最大,随着芯片技术节点不断提升,对晶圆表面污染物的控制要求也越来越高。
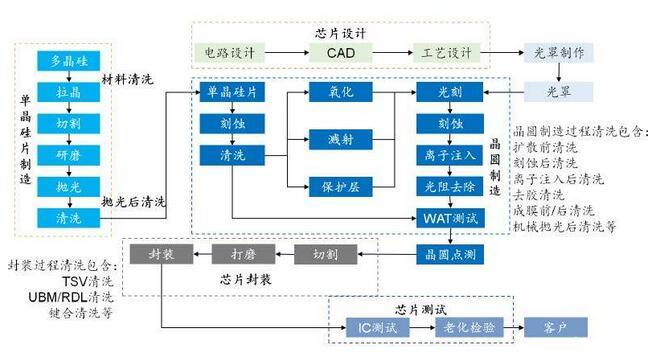
为了满足这些高的清洁度要求,在其中部分需要化学清洗的工序,清洗剂的浓度一定要保持在适当的浓度范围之内,成功的清洗工艺有两个条件:
1.为了达成所需的清洁效果,清洗剂的浓度需要在规定范围内。
2.在最后的漂洗过程后,须避免表面活性剂在硅晶圆上残留,残留的表面活性剂对后面的处理工艺会造成不利影响。
清洗工艺的好坏直接影响下一道工序,甚至影响器件的成品率和可靠性,然而在清洗工艺过程中,工人往往疏于监控清洗和漂洗工序中表面活性剂的浓度,表面活性剂经常过量,而为了消除表面活性剂过量带来的不利影响,又往往要费时费力地增加漂洗工序阶段的成本。
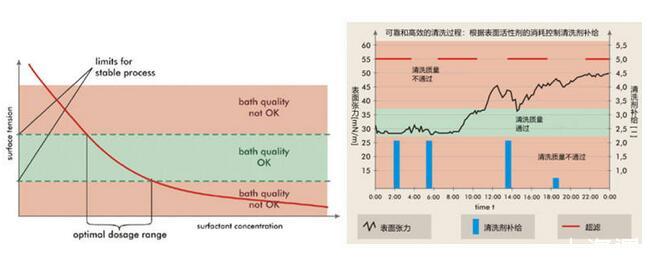
动态表面张力在半导体晶圆切片工艺的应用
半导体晶圆切片和CMP工艺要求
晶圆切片工艺是在“后端”装配工艺中的第一步。该工艺将晶圆分成单个的芯片,用于随后的芯片接合(die bonding)、引线接合(wire bonding)和测试工序。在芯片的分割期间,金刚石刀片碾碎基础材料(晶圆),同时去掉所产生的碎片。在切割晶圆时某一种特殊的处理液会用于冷却工作时的刀片,这种处理液中会加入某种表面活性剂,以此来润滑刀片并移除切割过程中产生的碎片,改善切割品质、延长刀片寿命。
在半导体晶圆CMP工艺中,利用机械力作用于晶圆片表面,同时研磨液中的化学物质与晶圆片表面材料发生化学反应来增加其研磨速率。
抛光液是CMP技术中的决定性因素之一,其性能直接影响被加工工件表面的质量以及抛光加工的效率。在CMP抛光液中,一般使用水基抛光液作为加工介质,以去离子水作为溶剂,加入磨料(如SiO2、ZrO2纳米粒子等)、分散剂、pH调节剂以及氧化剂等组分,每个组分都具有相应的功能,对化学机械抛光过程起到不同的作用。磨料通过抛光液输送到抛光垫表面后,在抛光垫和被加工表面之间同时受到压力作用以及相对运动的带动,通过对被加工表面形成极细微的切削、划擦以及滚压作用,对表面材料进行微量去除。磨料的形状、硬度、颗粒大小对化学机械抛光都具有重要的影响。分散剂是一种兼具亲水性与亲油性的界面活性剂,能够均匀分散一些不溶于液体的固体颗粒,对于抛光液而言,分散剂能够减少抛光液中磨料颗粒的团聚,提高抛光液中磨料的分散稳定性。










